Halbleiter-Laser-Lift-Off-Ausrüstung
Detailliertes Diagramm


Produktübersicht der Laser-Lift-Off-Ausrüstung
Die Halbleiter-Laser-Lift-Off-Anlage stellt eine zukunftsweisende Lösung für die fortschrittliche Ingot-Dünnung in der Halbleitermaterialverarbeitung dar. Im Gegensatz zu herkömmlichen Wafer-Verfahren, die auf mechanischem Schleifen, Diamantdrahtsägen oder chemisch-mechanischer Planarisierung basieren, bietet diese laserbasierte Plattform eine berührungslose, zerstörungsfreie Alternative zum Ablösen ultradünner Schichten von Halbleiter-Ingots.
Die Halbleiter-Laser-Lift-Off-Anlage wurde für spröde und hochwertige Materialien wie Galliumnitrid (GaN), Siliziumkarbid (SiC), Saphir und Galliumarsenid (GaAs) optimiert und ermöglicht das präzise Abtrennen von Wafer-großen Schichten direkt vom Kristallblock. Diese bahnbrechende Technologie reduziert den Materialverbrauch deutlich, erhöht den Durchsatz und verbessert die Substratintegrität – allesamt entscheidende Faktoren für zukünftige Bauelemente in der Leistungselektronik, HF-Systemen, Photonik und Mikrodisplays.
Mit Schwerpunkt auf automatisierter Steuerung, Strahlformung und Analyse der Laser-Material-Wechselwirkung ist die Halbleiter-Laser-Lift-Off-Anlage so konzipiert, dass sie sich nahtlos in die Arbeitsabläufe der Halbleiterfertigung integrieren lässt und gleichzeitig Flexibilität in Forschung und Entwicklung sowie Skalierbarkeit in der Massenproduktion unterstützt.

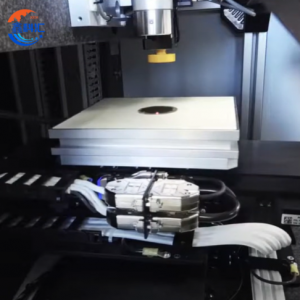
Technologie und Funktionsprinzip von Laser-Lift-Off-Geräten
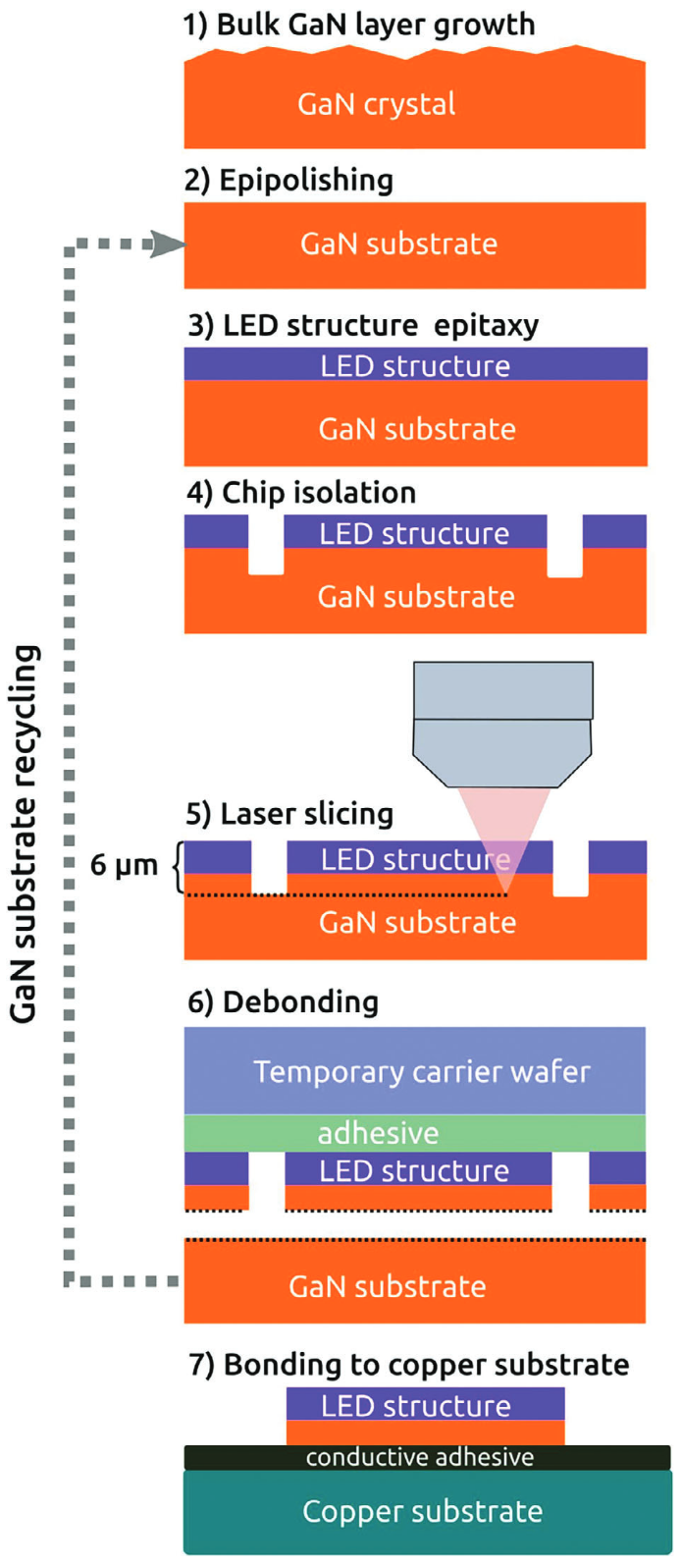
Das Verfahren, das mit Halbleiter-Laser-Lift-Off-Anlagen durchgeführt wird, beginnt mit der einseitigen Bestrahlung des Donator-Ingots mit einem hochenergetischen ultravioletten Laserstrahl. Dieser Strahl wird auf eine bestimmte innere Tiefe fokussiert, typischerweise entlang einer speziell entwickelten Grenzfläche, wo die Energieabsorption aufgrund optischer, thermischer oder chemischer Kontraste maximal ist.
In dieser Energieabsorptionsschicht führt lokale Erwärmung zu einer raschen Mikroexplosion, Gasausdehnung oder Zersetzung einer Grenzschicht (z. B. eines Spannungsfilms oder einer Opferoxidschicht). Diese präzise gesteuerte Zerstörung bewirkt, dass sich die obere, mehrere zehn Mikrometer dicke Kristallschicht sauber vom Grundblock ablöst.
Die Laser-Lift-Off-Anlage für Halbleiter nutzt bewegungssynchronisierte Scanköpfe, eine programmierbare Z-Achsen-Steuerung und Echtzeit-Reflektometrie, um sicherzustellen, dass jeder Laserpuls die Energie präzise auf die Zielebene abgibt. Die Anlage kann zudem mit Burst- oder Mehrpuls-Funktion konfiguriert werden, um die Ablösung zu optimieren und Restspannungen zu minimieren. Da der Laserstrahl das Material nie direkt berührt, wird das Risiko von Mikrorissen, Verformungen oder Oberflächenabsplitterungen drastisch reduziert.
Dies macht die Laser-Lift-off-Dünnungsmethode zu einem Wendepunkt, insbesondere bei Anwendungen, bei denen ultraflache, ultradünne Wafer mit einer Gesamtdickenvariation (TTV) im Submikrometerbereich benötigt werden.
Parameter der Halbleiter-Laser-Lift-Off-Anlage
| Wellenlänge | IR/SHG/THG/FHG |
|---|---|
| Impulsbreite | Nanosekunde, Pikosekunde, Femtosekunde |
| Optisches System | Festes optisches System oder galvano-optisches System |
| XY-Stadium | 500 mm × 500 mm |
| Verarbeitungsbereich | 160 mm |
| Bewegungsgeschwindigkeit | Max. 1000 mm/s |
| Wiederholbarkeit | ±1 μm oder weniger |
| Absolute Positionsgenauigkeit: | ±5 μm oder weniger |
| Wafergröße | 2–6 Zoll oder individuell angepasst |
| Kontrolle | Windows 10, 11 und SPS |
| Versorgungsspannung | Wechselstrom 200 V ±20 V, einphasig, 50/60 kHz |
| Äußere Abmessungen | 2400 mm (B) × 1700 mm (T) × 2000 mm (H) |
| Gewicht | 1.000 kg |
Industrielle Anwendungen von Laser-Lift-Off-Geräten
Laser-Lift-Off-Anlagen für Halbleiter verändern die Materialpräparation in verschiedenen Halbleiterbereichen rasant:
- Vertikale GaN-Leistungsbauelemente für Laser-Lift-Off-Anlagen
Das Ablösen ultradünner GaN-auf-GaN-Filme von massiven Ingots ermöglicht vertikale Leitungsarchitekturen und die Wiederverwendung teurer Substrate.
- SiC-Wafer-Dünnung für Schottky- und MOSFET-Bauelemente
Reduziert die Dicke der Bauelementschicht bei gleichzeitiger Erhaltung der Substratplanarität – ideal für schnell schaltende Leistungselektronik.
- Saphirbasierte LED- und Displaymaterialien für Laser-Lift-Off-Anlagen
Ermöglicht die effiziente Trennung der Geräteschichten von den Saphir-Boules und unterstützt so die Herstellung dünner, thermisch optimierter Mikro-LEDs.
- III-V-Werkstofftechnik für Laser-Lift-Off-Anlagen
Ermöglicht das Ablösen von GaAs-, InP- und AlGaN-Schichten für die fortschrittliche optoelektronische Integration.
- Herstellung von Dünnschicht-ICs und Sensoren
Produziert dünne Funktionsschichten für Drucksensoren, Beschleunigungsmesser oder Fotodioden, bei denen die Dicke des Materials ein Leistungsengpass ist.
- Flexible und transparente Elektronik
Stellt ultradünne Substrate her, die sich für flexible Displays, tragbare Schaltkreise und transparente intelligente Fenster eignen.
In all diesen Bereichen spielt die Halbleiter-Laser-Lift-Off-Ausrüstung eine entscheidende Rolle bei der Miniaturisierung, der Wiederverwendung von Materialien und der Vereinfachung von Prozessen.

Häufig gestellte Fragen (FAQ) zu Laser-Lift-Off-Geräten
Frage 1: Welche minimale Schichtdicke kann ich mit dem Halbleiter-Laser-Lift-Off-Gerät erreichen?
A1:Typischerweise zwischen 10 und 30 Mikrometern, abhängig vom Material. Mit modifizierten Aufbauten sind auch dünnere Schichten möglich.
Frage 2: Kann man damit mehrere Wafer aus demselben Ingot schneiden?
A2:Ja. Viele Kunden nutzen die Laser-Lift-off-Technik, um nacheinander mehrere dünne Schichten von einem massiven Block abzutrennen.
Frage 3: Welche Sicherheitsvorkehrungen sind für den Betrieb von Hochleistungslasern vorgesehen?
A3:Schutzgehäuse der Klasse 1, Verriegelungssysteme, Strahlenschutz und automatische Abschaltungen gehören zur Standardausstattung.
Frage 4: Wie schneidet dieses System im Vergleich zu Diamantseilsägen hinsichtlich der Kosten ab?
A4:Auch wenn die anfänglichen Investitionskosten höher sein mögen, reduziert das Laser-Lift-off-Verfahren die Kosten für Verbrauchsmaterialien, Substratschäden und Nachbearbeitungsschritte drastisch – was langfristig die Gesamtbetriebskosten (TCO) senkt.
Frage 5: Ist das Verfahren auf 6-Zoll- oder 8-Zoll-Barren skalierbar?
A5:Absolut. Die Plattform unterstützt Substrate bis zu 12 Zoll mit gleichmäßiger Strahlverteilung und großformatigen Bewegungstischen.
Über uns
XKH ist spezialisiert auf die Entwicklung, Produktion und den Vertrieb von Spezialglas und neuen Kristallmaterialien. Unsere Produkte finden Anwendung in der Optoelektronik, der Unterhaltungselektronik und im Militärbereich. Wir bieten optische Saphirkomponenten, Objektivabdeckungen für Mobiltelefone, Keramik, LT, Siliziumkarbid (SiC), Quarz und Halbleiterkristallwafer an. Dank unserer Expertise und modernster Ausrüstung zeichnen wir uns durch die Fertigung von Sonderanfertigungen aus und streben die Position eines führenden Hightech-Unternehmens für optoelektronische Materialien an.











