Einführung in Siliciumcarbid
Siliziumkarbid (SiC) ist ein Verbindungshalbleiter aus Kohlenstoff und Silizium und eignet sich ideal für die Herstellung von Hochtemperatur-, Hochfrequenz-, Hochleistungs- und Hochspannungsbauteilen. Im Vergleich zu herkömmlichem Silizium (Si) ist die Bandlücke von Siliziumkarbid dreimal so groß. Die Wärmeleitfähigkeit ist 4- bis 5-mal so hoch, die Durchbruchspannung 8- bis 10-mal so hoch und die elektronische Sättigungsdrift 2- bis 3-mal so hoch. Damit erfüllt es die Anforderungen der modernen Industrie an hohe Leistung, hohe Spannung und hohe Frequenz. Es wird hauptsächlich zur Herstellung von Hochgeschwindigkeits-, Hochfrequenz-, Hochleistungs- und Leuchtdioden-Elektronikbauteilen verwendet. Zu den Anwendungsgebieten zählen Smart Grids, Elektrofahrzeuge, Photovoltaik, Windkraft und 5G-Kommunikation. Siliziumkarbiddioden und MOSFETs werden bereits kommerziell eingesetzt.

Hohe Temperaturbeständigkeit. Die Bandlückenbreite von Siliziumkarbid ist 2-3 Mal so groß wie die von Silizium. Dadurch werden Elektronenübergänge bei hohen Temperaturen erschwert, und das Material hält höheren Betriebstemperaturen stand. Die Wärmeleitfähigkeit von Siliziumkarbid ist 4-5 Mal so hoch wie die von Silizium, was die Wärmeableitung des Bauelements erleichtert und die maximale Betriebstemperatur erhöht. Die hohe Temperaturbeständigkeit ermöglicht eine deutliche Steigerung der Leistungsdichte bei gleichzeitig reduzierten Anforderungen an das Kühlsystem, wodurch die Bauelemente leichter und kleiner werden können.
Hohem Druck standhalten. Die Durchschlagsfeldstärke von Siliziumkarbid ist 10-mal höher als die von Silizium, wodurch es höheren Spannungen standhält und sich besser für Hochspannungsgeräte eignet.
Hochfrequenzwiderstand. Siliziumkarbid besitzt eine doppelt so hohe Sättigungs-Elektronendriftgeschwindigkeit wie Silizium, was zu einem Ausbleiben des Stromnachlaufs während des Abschaltvorgangs führt. Dies kann die Schaltfrequenz des Bauelements effektiv verbessern und dessen Miniaturisierung ermöglichen.
Geringe Energieverluste. Siliziumkarbid weist im Vergleich zu Silizium einen sehr niedrigen Einschaltwiderstand und geringe Einschaltverluste auf. Gleichzeitig reduziert die hohe Bandlückenbreite von Siliziumkarbid den Leckstrom und die Leistungsverluste erheblich. Darüber hinaus zeigt das Siliziumkarbidbauelement beim Abschaltvorgang kein Nachlaufen des Stroms, und die Schaltverluste sind gering.
Siliziumkarbid-Industriekette
Die Herstellung umfasst im Wesentlichen Substrat, Epitaxie, Gerätedesign, Fertigung, Versiegelung usw. Siliziumkarbid durchläuft vom Ausgangsmaterial bis zum Halbleiter-Leistungsbauelement Prozesse wie Einkristallzüchtung, Ingot-Sägen, epitaktisches Wachstum, Wafer-Design, Fertigung und Verpackung. Nach der Synthese des Siliziumkarbidpulvers wird zunächst der Siliziumkarbid-Ingot hergestellt. Anschließend wird durch Schneiden, Schleifen und Polieren das Siliziumkarbid-Substrat gewonnen, und durch epitaktisches Wachstum entsteht die Epitaxieschicht. Der Epitaxie-Wafer wird aus Siliziumkarbid mittels Lithographie, Ätzen, Ionenimplantation, Metallpassivierung und weiteren Prozessen hergestellt. Der Wafer wird in Chips geschnitten, das Bauelement verpackt und in ein spezielles Gehäuse integriert, um ein Modul zu bilden.
Vorgelagerter Teil der industriellen Wertschöpfungskette 1: Substrat – Kristallwachstum ist das Kernprozessglied
Das Siliziumkarbidsubstrat macht etwa 47 % der Kosten von Siliziumkarbidbauelementen aus, stellt die größten technischen Hürden in der Fertigung dar, ist der größte Wert und bildet den Kern der zukünftigen großtechnischen Industrialisierung von SiC.
Hinsichtlich ihrer elektrochemischen Eigenschaften lassen sich Siliziumkarbid-Substratmaterialien in leitfähige Substrate (spezifischer Widerstandsbereich 15–30 mΩ·cm) und halbisolierende Substrate (spezifischer Widerstand > 10⁵ Ω·cm) unterteilen. Diese beiden Substrattypen werden nach epitaktischem Wachstum zur Herstellung diskreter Bauelemente wie Leistungshalbleiter bzw. Hochfrequenzbauelemente verwendet. Halbisolierende Siliziumkarbid-Substrate kommen hauptsächlich bei der Fertigung von Galliumnitrid-Hochfrequenzbauelementen, Fotodioden usw. zum Einsatz. Durch das Aufwachsen einer Galliumnitrid-Epitaxieschicht auf einem halbisolierenden Siliziumkarbid-Substrat entsteht eine Siliziumkarbid-Epitaxieplatte, die anschließend zu HEMT-Galliumnitrid-Hochfrequenzbauelementen weiterverarbeitet werden kann. Leitfähige Siliziumkarbid-Substrate werden hauptsächlich in der Herstellung von Leistungshalbleitern verwendet. Anders als bei der Herstellung herkömmlicher Silizium-Leistungshalbleiter kann ein Siliziumkarbid-Leistungshalbleiter nicht direkt auf dem Siliziumkarbid-Substrat hergestellt werden. Stattdessen muss eine Siliziumkarbid-Epitaxieschicht auf einem leitfähigen Substrat aufgebracht werden, um die Siliziumkarbid-Epitaxieschicht zu erhalten. Diese Epitaxieschicht wird dann auf Schottky-Dioden, MOSFETs, IGBTs und anderen Leistungshalbleitern aufgebracht.
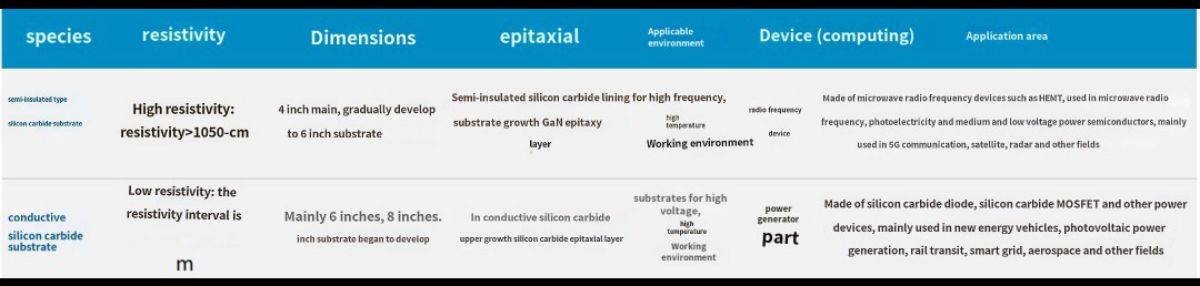
Siliciumcarbidpulver wurde aus hochreinem Kohlenstoffpulver und hochreinem Siliciumpulver synthetisiert. Unter einem speziellen Temperaturfeld wurden Siliciumcarbid-Ingots unterschiedlicher Größe gezüchtet, woraus anschließend durch mehrere Verarbeitungsprozesse ein Siliciumcarbid-Substrat hergestellt wurde. Der Kernprozess umfasst:
Rohstoffsynthese: Hochreines Siliciumpulver und Toner werden gemäß der vorgegebenen Rezeptur vermischt. Die Reaktion erfolgt in der Reaktionskammer bei Temperaturen über 2000 °C, um Siliciumcarbidpartikel mit spezifischer Kristallstruktur und Partikelgröße zu synthetisieren. Anschließend werden die Partikel durch Zerkleinern, Sieben, Reinigen und weitere Prozesse aufbereitet, um die Anforderungen an hochreines Siliciumcarbidpulver als Rohstoff zu erfüllen.
Das Kristallwachstum ist der Kernprozess bei der Herstellung von Siliziumkarbidsubstraten und bestimmt deren elektrische Eigenschaften. Die wichtigsten Verfahren für das Kristallwachstum sind derzeit die physikalische Dampfphasenabscheidung (PVT), die Hochtemperatur-CVD (HT-CVD) und die Flüssigphasenepitaxie (LPE). Die PVT-Methode ist aktuell das gängigste Verfahren für die kommerzielle Herstellung von SiC-Substraten, da sie den höchsten technischen Reifegrad aufweist und in der Praxis am weitesten verbreitet ist.

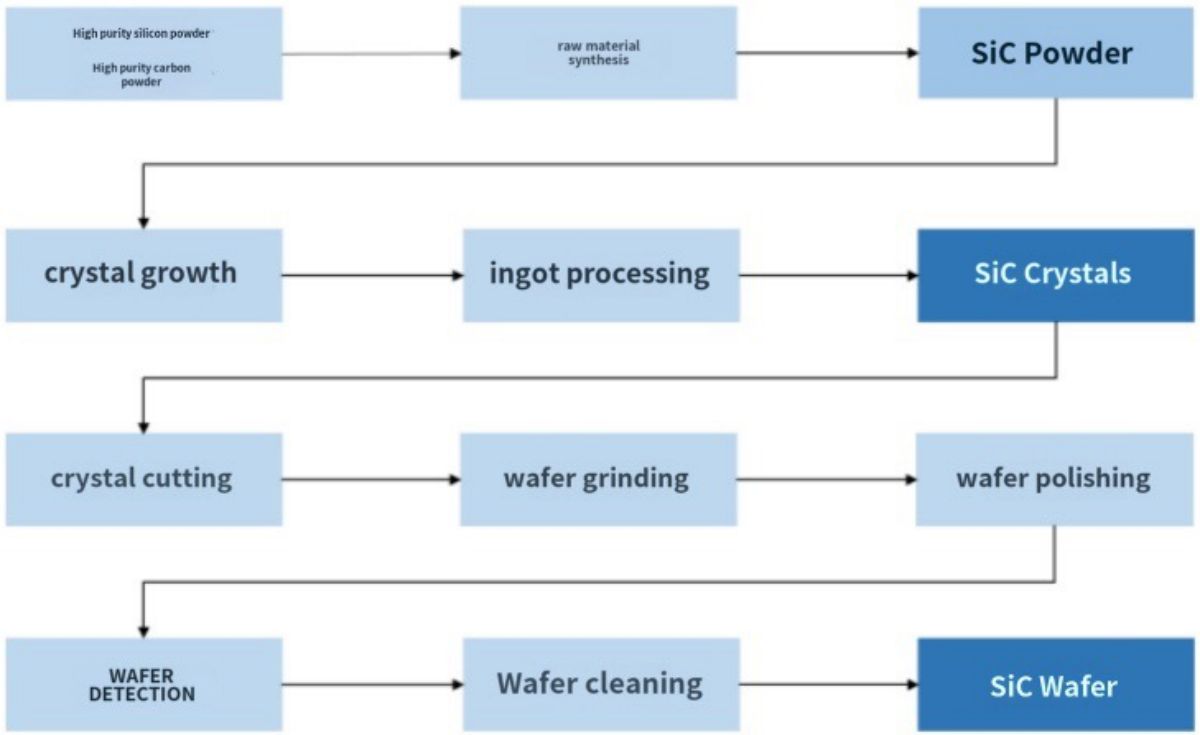
Die Herstellung des SiC-Substrats ist schwierig, was zu seinem hohen Preis führt.
Die Temperaturfeldkontrolle ist schwierig: Für das Wachstum von Siliziumkristallstäben reichen 1500 °C aus, während Siliziumkarbidkristallstäbe bei Temperaturen über 2000 °C gezüchtet werden müssen. Es existieren mehr als 250 SiC-Isomere, wobei die 4H-SiC-Einkristallstruktur für die Herstellung von Leistungshalbleitern die Hauptkomponente darstellt. Ohne präzise Temperaturkontrolle entstehen andere Kristallstrukturen. Darüber hinaus bestimmt der Temperaturgradient im Tiegel die Geschwindigkeit des SiC-Sublimationstransfers sowie die Anordnung und das Wachstumsmuster der Gasatome an der Kristallgrenzfläche. Dies beeinflusst die Kristallwachstumsrate und -qualität. Daher ist die Entwicklung einer systematischen Temperaturfeldkontrolltechnologie unerlässlich. Im Vergleich zu Siliziummaterialien unterscheiden sich die SiC-Herstellungsprozesse auch hinsichtlich der Hochtemperaturverfahren wie Hochtemperatur-Ionenimplantation, Hochtemperatur-Oxidation, Hochtemperatur-Aktivierung und der für diese Prozesse erforderlichen Hartmaskierung.
Langsames Kristallwachstum: Die Wachstumsrate von Si-Kristallstäben kann 30–150 mm/h erreichen, und die Herstellung von 1–3 m langen Silizium-Kristallstäben dauert nur etwa 1 Tag; bei SiC-Kristallstäben, die beispielsweise mit dem PVT-Verfahren hergestellt werden, beträgt die Wachstumsrate etwa 0,2–0,4 mm/h, und in 7 Tagen wachsen weniger als 3–6 cm, die Wachstumsrate beträgt weniger als 1 % des Siliziummaterials, die Produktionskapazität ist extrem begrenzt.
Hohe Produktparameter und geringe Ausbeute: Zu den Kernparametern des SiC-Substrats gehören die Mikrotubulidichte, die Versetzungsdichte, der spezifische Widerstand, die Verformung, die Oberflächenrauheit usw. Es ist eine komplexe Systemtechnik, Atome in einer geschlossenen Hochtemperaturkammer anzuordnen und das Kristallwachstum abzuschließen, während gleichzeitig die Parameterindizes kontrolliert werden.
Das Material weist eine hohe Härte und Sprödigkeit auf und erfordert lange Bearbeitungszeiten sowie hohen Verschleiß: Mit einer Mohs-Härte von 9,25 steht SiC an zweiter Stelle nach Diamant. Dies erschwert das Schneiden, Schleifen und Polieren erheblich; die Bearbeitung eines 3 cm dicken Ingots mit 35–40 Teilen dauert etwa 120 Stunden. Aufgrund der hohen Sprödigkeit von SiC ist der Verschleiß bei der Waferbearbeitung zudem höher, und die Ausbeute beträgt lediglich etwa 60 %.
Entwicklungstrend: Größenwachstum + Preissenkung
Der globale Markt für 6-Zoll-SiC-Produktionslinien ist ausgereift, und führende Unternehmen haben den 8-Zoll-Markt betreten. Inländische Entwicklungsprojekte konzentrieren sich hauptsächlich auf 6-Zoll-Wafer. Obwohl die meisten inländischen Unternehmen derzeit noch auf 4-Zoll-Produktionslinien basieren, expandiert die Branche schrittweise auf 6 Zoll. Mit der zunehmenden Reife der 6-Zoll-Zusatzausrüstungstechnologie und der stetigen Verbesserung der inländischen SiC-Substrattechnologie werden sich die Skaleneffekte großflächiger Produktionslinien bemerkbar machen, und die verbleibende Zeitspanne bis zur Massenproduktion von 6-Zoll-Wafern in China hat sich auf 7 Jahre verkürzt. Die größere Wafergröße ermöglicht eine höhere Anzahl einzelner Chips, eine verbesserte Ausbeute und einen geringeren Anteil an Randchips. Die Kosten für Forschung und Entwicklung sowie die Ausbeuteverluste werden bei etwa 7 % gehalten, wodurch die Wafernutzung verbessert wird.
Bei der Geräteentwicklung bestehen nach wie vor viele Schwierigkeiten.
Die Kommerzialisierung von SiC-Dioden schreitet stetig voran. Zahlreiche inländische Hersteller bieten mittlerweile SiC-SBD-Produkte an, die sich durch gute Stabilität im Mittel- und Hochspannungsbereich auszeichnen. Im Bordcomputer von Fahrzeugen wird durch den Einsatz von SiC-SBD in Kombination mit Si-IGBT eine stabile Stromdichte erreicht. Derzeit bestehen in China keine Patentbarrieren für SiC-SBD-Produkte, und der Rückstand gegenüber dem Ausland ist gering.
SiC-MOS-Technologie steht nach wie vor vor vielen Herausforderungen. Es besteht weiterhin eine Lücke zwischen SiC-MOS-Herstellern und ausländischen Anbietern, und die entsprechende Fertigungsplattform befindet sich noch im Aufbau. Aktuell haben ST, Infineon, Rohm und andere Hersteller von 600-1700-V-SiC-MOS-Technologie die Serienproduktion erreicht und Verträge mit zahlreichen Fertigungsunternehmen abgeschlossen und ausgeliefert. Die Entwicklung von SiC-MOS-Technologie in China ist hingegen weitgehend abgeschlossen. Einige Designhersteller arbeiten bereits mit Halbleiterwerken in der Wafer-Flow-Phase zusammen, und die anschließende Kundenvalidierung benötigt noch Zeit. Daher ist es noch ein weiter Weg bis zur großflächigen Kommerzialisierung.
Aktuell ist die planare Struktur die gängigste Wahl, während die Grabenstruktur zukünftig vor allem im Hochdruckbereich weit verbreitet sein wird. Es gibt zahlreiche Hersteller von SiC-MOSFETs mit planarer Struktur. Im Vergleich zur Grabenstruktur ist die planare Struktur weniger anfällig für lokale Durchschläge, die die Stabilität beeinträchtigen könnten. Sie findet breite Anwendung im Marktsegment unter 1200 V und ist zudem relativ einfach herzustellen, wodurch die Anforderungen an Herstellbarkeit und Kostenkontrolle erfüllt werden. Grabenstrukturen zeichnen sich durch extrem niedrige parasitäre Induktivität, hohe Schaltgeschwindigkeit, geringe Verluste und vergleichsweise hohe Leistung aus.
2 – Neuigkeiten zu SiC-Wafern
Wachstum der Produktion und des Absatzes auf dem Siliziumkarbidmarkt – achten Sie auf das strukturelle Ungleichgewicht zwischen Angebot und Nachfrage.


Mit dem rasanten Wachstum der Marktnachfrage nach Hochfrequenz- und Hochleistungselektronik traten die physikalischen Grenzen siliziumbasierter Halbleiterbauelemente immer deutlicher zutage, und Halbleitermaterialien der dritten Generation, allen voran Siliziumkarbid (SiC), wurden zunehmend industriell eingesetzt. Siliziumkarbid weist eine dreifach höhere Bandlückenbreite als Silizium, eine zehnfach höhere kritische Durchbruchfeldstärke und eine dreifach höhere Wärmeleitfähigkeit auf. Daher eignen sich Siliziumkarbid-Leistungsbauelemente für Anwendungen unter hohen Frequenzen, hohen Drücken, hohen Temperaturen und tragen zur Verbesserung der Effizienz und Leistungsdichte von Leistungselektroniksystemen bei.
Derzeit sind SiC-Dioden und SiC-MOSFETs zunehmend auf dem Markt vertreten und es gibt immer mehr ausgereifte Produkte. SiC-Dioden werden in einigen Bereichen anstelle von Siliziumdioden eingesetzt, da diese keine Sperrverzögerungsladung aufweisen. SiC-MOSFETs finden ebenfalls zunehmend Anwendung in der Automobilindustrie, bei Energiespeichern, Ladesäulen, in der Photovoltaik und anderen Bereichen. Im Automobilbereich gewinnt die Modularisierung immer mehr an Bedeutung. Um die überlegene Leistung von SiC zu erzielen, sind fortschrittliche Gehäuseverfahren erforderlich. Technisch gesehen ist die Gehäuseversiegelung der gängigste Ansatz. Die zukünftige Entwicklung hin zur Kunststoffversiegelung und die damit verbundenen kundenspezifischen Entwicklungsmöglichkeiten eignen sich besonders für SiC-Module.
Geschwindigkeit des Preisverfalls von Siliziumkarbid – oder unvorstellbar schnell

Die Anwendung von Siliziumkarbid-Bauelementen wird hauptsächlich durch die hohen Kosten eingeschränkt. SiC-MOSFETs sind im Vergleich zu Si-basierten IGBTs viermal so teuer. Dies liegt an der komplexen Verarbeitung von Siliziumkarbid. Das Wachstum von Einkristallen und Epitaxie ist nicht nur umweltschädlich, sondern verläuft auch langsam. Die Weiterverarbeitung der Einkristalle zum Substrat erfordert zudem Schneid- und Polierprozesse. Aufgrund der Materialeigenschaften und der noch nicht ausgereiften Verarbeitungstechnologie liegt die Substratausbeute in China unter 50 %. Verschiedene Faktoren tragen zu den hohen Preisen für Substrate und Epitaxie bei.
Die Kostenstruktur von Siliziumkarbid- und Silizium-basierten Bauelementen ist jedoch diametral entgegengesetzt. Die Kosten für Substrat und Epitaxie des vorderen Kanals machen 47 % bzw. 23 % der Gesamtkosten aus, insgesamt also etwa 70 %. Die Kosten für Design, Fertigung und Versiegelung des hinteren Kanals belaufen sich hingegen nur auf 30 %. Bei Silizium-basierten Bauelementen konzentrieren sich die Produktionskosten hauptsächlich auf die Waferherstellung des hinteren Kanals (ca. 50 %), während die Substratkosten lediglich 7 % ausmachen. Diese umgekehrte Wertschöpfungskette der Siliziumkarbidindustrie bedeutet, dass die Hersteller von Substrat-Epitaxieprodukten eine zentrale Rolle spielen und somit entscheidend für die Positionierung in- und ausländischer Unternehmen sind.
Aus dynamischer Marktperspektive führt die Senkung der Siliziumkarbidkosten, neben der Verbesserung des Siliziumkarbid-Langkristall- und Schneidprozesses, zur Vergrößerung der Wafergröße. Dies ist ein bewährter Weg der Halbleiterentwicklung. Daten von Wolfspeed zeigen, dass die Vergrößerung des Siliziumkarbidsubstrats von 6 auf 8 Zoll die Produktion qualifizierter Chips um 80–90 % steigern und die Ausbeute verbessern kann. Dadurch lassen sich die kombinierten Stückkosten um 50 % senken.
2023 gilt als das „erste Jahr des 8-Zoll-SiC“. In diesem Jahr beschleunigen in- und ausländische Siliziumkarbidhersteller den Ausbau ihrer Produktionsanlagen für 8-Zoll-Siliziumkarbid. So investierte beispielsweise Wolfspeed unglaubliche 14,55 Milliarden US-Dollar in die Erweiterung der Siliziumkarbidproduktion, wobei ein wichtiger Bestandteil der Bau einer Produktionsanlage für 8-Zoll-SiC-Substrate ist. Dies soll die zukünftige Versorgung zahlreicher Unternehmen mit 200-mm-SiC-Rohmetall sicherstellen. Auch die chinesischen Unternehmen Tianyue Advanced und Tianke Heda haben langfristige Verträge mit Infineon zur zukünftigen Lieferung von 8-Zoll-Siliziumkarbidsubstraten unterzeichnet.
Ab diesem Jahr wird die Siliziumkarbid-Technologie von 6 auf 8 Zoll expandieren. Wolfspeed geht davon aus, dass die Stückkosten für 8-Zoll-Substrate bis 2024 im Vergleich zu den Stückkosten für 6-Zoll-Substrate im Jahr 2022 um mehr als 60 % sinken werden. Laut Daten von Ji Bond Consulting wird diese Kostensenkung den Anwendungsmarkt weiter erschließen. Derzeit liegt der Marktanteil von 8-Zoll-Produkten bei unter 2 % und soll bis 2026 auf rund 15 % ansteigen.
Tatsächlich dürfte der Preisverfall bei Siliziumkarbidsubstraten die Erwartungen vieler übertreffen. Derzeit liegt der Marktpreis für 6-Zoll-Substrate bei 4000–5000 Yuan pro Stück, was im Vergleich zum Jahresbeginn einen deutlichen Rückgang darstellt. Es wird erwartet, dass der Preis im nächsten Jahr unter 4000 Yuan fallen wird. Bemerkenswert ist, dass einige Hersteller, um sich einen Wettbewerbsvorteil zu sichern, die Verkaufspreise bis unter die Selbstkosten gesenkt und damit einen Preiskampf entfacht haben. Obwohl das Angebot an Siliziumkarbidsubstraten im Niederspannungsbereich relativ ausreichend war, bauen in- und ausländische Hersteller ihre Produktionskapazitäten massiv aus, was zu einem früheren Überangebot an Siliziumkarbidsubstraten führen könnte als erwartet.
Veröffentlichungsdatum: 19. Januar 2024
