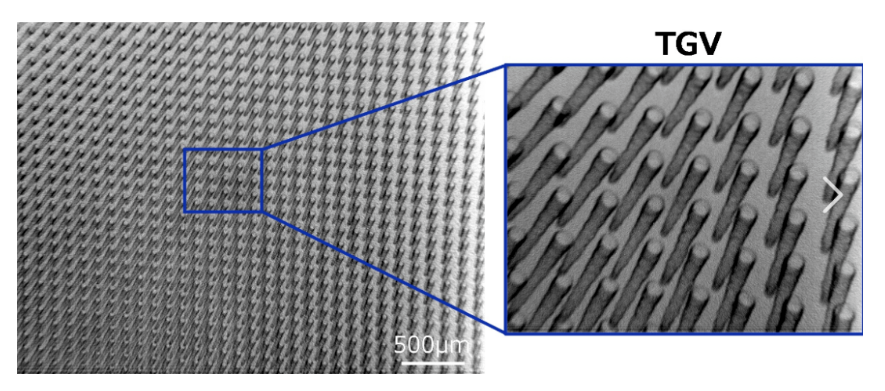
Was ist TGV?
TGV, (Durchglas-Durchgang)Die TGV-Technologie (Thin Gandhi Digital Visual Building) ist eine Technologie zur Herstellung von Durchgangslöchern in einem Glassubstrat. Vereinfacht gesagt, handelt es sich um ein Hochhaus, das durch Stanzen, Füllen und Verbinden von oben und unten in das Glas integrierte Schaltkreise auf dem Glasboden erzeugt. Diese Technologie gilt als Schlüsseltechnologie für die nächste Generation der 3D-Gehäusefertigung.

Was sind die Merkmale des TGV?
1. Aufbau: TGV ist eine vertikal durchdringende, leitfähige Durchgangsbohrung in einem Glassubstrat. Durch Aufbringen einer leitfähigen Metallschicht auf die Porenwand werden die oberen und unteren Schichten elektrischer Signale miteinander verbunden.
2. Herstellungsprozess: Die TGV-Herstellung umfasst die Substratvorbehandlung, die Lochherstellung, die Metallisierung, das Füllen der Löcher und das Glätten. Gängige Herstellungsverfahren sind chemisches Ätzen, Laserbohren, Galvanisieren usw.
3. Anwendungsvorteile: Im Vergleich zu herkömmlichen Metall-Durchkontaktierungen bietet die TGV-Technologie Vorteile wie geringere Größe, höhere Leiterdichte und bessere Wärmeableitung. Sie findet breite Anwendung in der Mikroelektronik, Optoelektronik, MEMS und anderen Bereichen mit hochdichten Verbindungen.
4. Entwicklungstrend: Mit der Miniaturisierung und Hochintegration elektronischer Produkte gewinnt die TGV-Technologie zunehmend an Bedeutung und Anwendung. Zukünftig werden die Fertigungsprozesse weiter optimiert und Größe und Leistung kontinuierlich verbessert.
Was ist der TGV-Prozess?
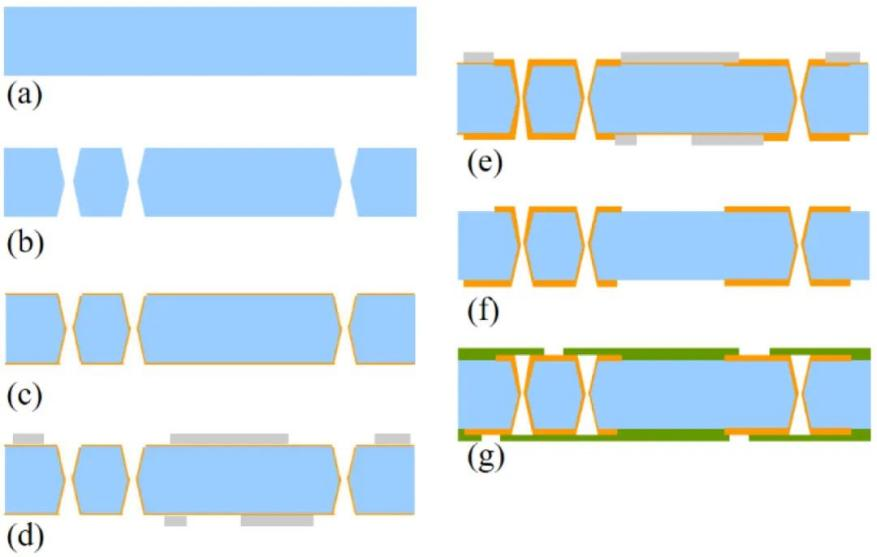
1. Vorbereitung des Glassubstrats (a) : Bereiten Sie zu Beginn ein Glassubstrat vor, um sicherzustellen, dass seine Oberfläche glatt und sauber ist.
2. Glasbohren (b): Ein Laser erzeugt ein Durchdringungsloch im Glassubstrat. Das Loch hat im Allgemeinen eine konische Form und wird nach der Laserbehandlung einer Seite gewendet und auf der anderen Seite bearbeitet.
3. Lochwandmetallisierung (c): Die Metallisierung erfolgt an der Lochwand, üblicherweise durch PVD, CVD und andere Verfahren, um eine leitfähige Metallkeimschicht an der Lochwand zu bilden, wie z. B. Ti/Cu, Cr/Cu usw.
4. Lithographie (d): Die Oberfläche des Glassubstrats wird mit Fotolack beschichtet und fotostrukturiert. Die Bereiche, die nicht beschichtet werden müssen, werden belichtet, sodass nur die zu beschichtenden Bereiche belichtet werden.
5. Lochfüllung (e): Durch galvanische Abscheidung von Kupfer werden die Löcher im Glas gefüllt, um einen durchgehenden Leiter zu schaffen. Im Allgemeinen ist es erforderlich, dass die Löcher vollständig und ohne weitere Löcher gefüllt sind. Beachten Sie, dass die Kupferschicht im Diagramm nicht vollständig gefüllt ist.
6. Ebene Oberfläche des Substrats (f): Bei einigen TGV-Prozessen wird die Oberfläche des gefüllten Glassubstrats geglättet, um sicherzustellen, dass die Oberfläche des Substrats glatt ist, was den nachfolgenden Prozessschritten förderlich ist.
7. Schutzschicht und Anschluss (g) : Auf der Oberfläche des Glassubstrats wird eine Schutzschicht (z. B. Polyimid) gebildet.
Kurz gesagt, ist jeder Schritt des TGV-Prozesses entscheidend und erfordert präzise Steuerung und Optimierung. Wir bieten Ihnen bei Bedarf die TGV-Durchstecktechnologie für Glas an. Kontaktieren Sie uns gerne!
(Die obigen Informationen stammen aus dem Internet und wurden zensiert.)
Veröffentlichungsdatum: 25. Juni 2024
