Obwohl Silizium- und Glaswafer das gemeinsame Ziel der Reinigung verfolgen, unterscheiden sich die Herausforderungen und Fehlerquellen während des Reinigungsprozesses erheblich. Diese Diskrepanz resultiert aus den inhärenten Materialeigenschaften und Spezifikationsanforderungen von Silizium und Glas sowie aus der jeweils unterschiedlichen Reinigungsphilosophie, die durch die jeweiligen Endanwendungen bestimmt wird.
Zunächst einmal sollten wir klären: Was genau reinigen wir? Um welche Verunreinigungen handelt es sich?
Verunreinigungen lassen sich in vier Kategorien einteilen:
-
Partikelverunreinigungen
-
Staub, Metallpartikel, organische Partikel, abrasive Partikel (aus dem CMP-Prozess) usw.
-
Diese Verunreinigungen können zu Schaltungsfehlern wie Kurzschlüssen oder offenen Stromkreisen führen.
-
-
Organische Verunreinigungen
-
Beinhaltet Fotolackrückstände, Harzzusätze, Hautfette, Lösungsmittelrückstände usw.
-
Organische Verunreinigungen können Masken bilden, die das Ätzen oder die Ionenimplantation behindern und die Haftung anderer dünner Schichten verringern.
-
-
Metallionenverunreinigungen
-
Eisen, Kupfer, Natrium, Kalium, Kalzium usw., die hauptsächlich aus Geräten, Chemikalien und dem Kontakt mit Menschen stammen.
-
In Halbleitern wirken Metallionen als schädliche Verunreinigungen, da sie Energieniveaus im verbotenen Band einführen. Dies führt zu erhöhtem Leckstrom, verkürzter Ladungsträgerlebensdauer und erheblichen Beeinträchtigungen der elektrischen Eigenschaften. In Glas können sie die Qualität und Haftung nachfolgender Dünnschichten beeinträchtigen.
-
-
Natürliche Oxidschicht
-
Bei Siliziumwafern bildet sich an der Luft auf der Oberfläche auf natürliche Weise eine dünne Schicht aus Siliziumdioxid (natives Oxid). Dicke und Gleichmäßigkeit dieser Oxidschicht sind schwer zu kontrollieren, und sie muss bei der Herstellung wichtiger Strukturen wie Gate-Oxiden vollständig entfernt werden.
-
Bei Glasscheiben: Glas selbst ist eine Siliziumdioxid-Netzwerkstruktur, daher stellt sich nicht die Frage der „Entfernung einer natürlichen Oxidschicht“. Die Oberfläche kann jedoch durch Verunreinigungen verändert worden sein, und diese Schicht muss entfernt werden.
-

I. Kernziele: Die Diskrepanz zwischen elektrischer Leistung und physikalischer Perfektion
-
Siliziumwafer
-
Das Hauptziel der Reinigung ist die Sicherstellung der elektrischen Leistungsfähigkeit. Die Spezifikationen umfassen typischerweise strenge Vorgaben hinsichtlich Partikelanzahl und -größe (z. B. müssen Partikel ≥ 0,1 μm effektiv entfernt werden), Metallionenkonzentrationen (z. B. müssen Fe- und Cu-Konzentrationen auf ≤ 10¹⁰ Atome/cm² oder darunter begrenzt werden) sowie den Gehalt an organischen Rückständen. Selbst mikroskopische Verunreinigungen können zu Kurzschlüssen, Leckströmen oder einer Beschädigung der Gate-Oxid-Integrität führen.
-
-
Glasplättchen
-
Als Substrate sind physikalische Perfektion und chemische Stabilität die wichtigsten Anforderungen. Die Spezifikationen konzentrieren sich auf makroskopische Aspekte wie die Abwesenheit von Kratzern und nicht entfernbaren Flecken sowie den Erhalt der ursprünglichen Oberflächenrauheit und -geometrie. Ziel der Reinigung ist primär die Gewährleistung optischer Sauberkeit und guter Haftung für nachfolgende Prozesse wie Beschichtungen.
-
II. Materialbeschaffenheit: Der grundlegende Unterschied zwischen kristallinen und amorphen Strukturen
-
Silizium
-
Silizium ist ein kristallines Material, dessen Oberfläche natürlicherweise eine ungleichmäßige Siliziumdioxid-Oxidschicht (SiO₂) bildet. Diese Oxidschicht kann die elektrischen Eigenschaften beeinträchtigen und muss daher gründlich und gleichmäßig entfernt werden.
-
-
Glas
-
Glas ist ein amorphes Siliciumdioxidnetzwerk. Sein Grundmaterial ähnelt in seiner Zusammensetzung der Siliciumdioxidschicht von Silicium. Daher lässt es sich schnell mit Flusssäure (HF) ätzen und ist zudem anfällig für starke Laugenkorrosion, was zu erhöhter Oberflächenrauheit oder Verformung führt. Dieser grundlegende Unterschied bedingt, dass die Reinigung von Siliciumwafern leichtes, kontrolliertes Ätzen zur Entfernung von Verunreinigungen verträgt, während die Reinigung von Glaswafern äußerst sorgfältig erfolgen muss, um das Basismaterial nicht zu beschädigen.
-
| Reinigungsartikel | Siliziumwafer-Reinigung | Reinigung von Glasplättchen |
|---|---|---|
| Reinigungsziel | Beinhaltet eine eigene native Oxidschicht | Reinigungsmethode auswählen: Verunreinigungen entfernen und gleichzeitig das Grundmaterial schützen |
| Standard-RCA-Reinigung | - SPM(H₂SO₄/H₂O₂): Entfernt organische Rückstände/Fotolackreste | Hauptreinigungsablauf: |
| - SC1(NH₄OH/H₂O₂/H₂O): Entfernt Oberflächenpartikel | Schwach alkalisches ReinigungsmittelEnthält aktive Oberflächenmittel zur Entfernung organischer Verunreinigungen und Partikel | |
| - DHF(Fluorwasserstoffsäure): Entfernt die natürliche Oxidschicht und andere Verunreinigungen | Stark alkalisches oder mittelalkalisches ReinigungsmittelWird zur Entfernung metallischer oder nichtflüchtiger Verunreinigungen verwendet | |
| - SC2(HCl/H₂O₂/H₂O): Entfernt Metallverunreinigungen | Vermeiden Sie HF durchgehend | |
| Schlüsselchemikalien | Starke Säuren, starke Laugen, oxidierende Lösungsmittel | Schwach alkalisches Reinigungsmittel, speziell entwickelt zur Entfernung leichter Verschmutzungen |
| Körperliche Hilfsmittel | Deionisiertes Wasser (für hochreines Spülen) | Ultraschall-, Megaschallreinigung |
| Trocknungstechnologie | Megasonic, IPA-Dampftrocknung | Schonendes Trocknen: Langsames Anheben, IPA-Dampftrocknung |
III. Vergleich der Reinigungslösungen
Aufgrund der zuvor genannten Ziele und Materialeigenschaften unterscheiden sich die Reinigungslösungen für Silizium- und Glaswafer:
| Siliziumwafer-Reinigung | Reinigung von Glasplättchen | |
|---|---|---|
| Reinigungsziel | Gründliche Entfernung, einschließlich der nativen Oxidschicht des Wafers. | Selektive Entfernung: Schadstoffe werden beseitigt, während das Substrat geschützt wird. |
| Typischer Prozess | Standard-RCA-Clean:•SPM(H₂SO₄/H₂O₂): Entfernt schwere organische Stoffe/Fotolack •SC1(NH₄OH/H₂O₂/H₂O): alkalische Partikelentfernung •DHF(verdünnte HF): entfernt die natürliche Oxidschicht und Metalle •SC2(HCl/H₂O₂/H₂O): entfernt Metallionen | Charakteristischer Reinigungsablauf:•Mild-alkalischer Reinigermit Tensiden zur Entfernung von organischen Stoffen und Partikeln •Saurer oder neutraler Reinigerzur Entfernung von Metallionen und anderen spezifischen Verunreinigungen •Vermeiden Sie HF während des gesamten Prozesses |
| Schlüsselchemikalien | Starke Säuren, starke Oxidationsmittel, alkalische Lösungen | Mild-alkalische Reiniger; spezielle neutrale oder leicht saure Reiniger |
| Körperliche Unterstützung | Megaschall (hocheffiziente, schonende Partikelentfernung) | Ultraschall, Megaschall |
| Trocknung | Marangoni-Trocknung; IPA-Dampftrocknung | Langsame Trocknung; IPA-Dampftrocknung |
-
Reinigungsprozess für Glasplättchen
-
Derzeit verwenden die meisten Glasverarbeitungsanlagen Reinigungsverfahren, die auf den Materialeigenschaften von Glas basieren und sich vorwiegend auf schwach alkalische Reinigungsmittel stützen.
-
Eigenschaften des Reinigungsmittels:Diese Spezialreiniger sind typischerweise schwach alkalisch mit einem pH-Wert um 8-9. Sie enthalten üblicherweise Tenside (z. B. Alkylpolyoxyethylenether), Metallchelatbildner (z. B. HEDP) und organische Reinigungshilfsmittel, die organische Verunreinigungen wie Öle und Fingerabdrücke emulgieren und zersetzen und dabei die Glasmatrix möglichst wenig angreifen.
-
Prozessablauf:Das typische Reinigungsverfahren umfasst die Verwendung einer spezifischen Konzentration schwach alkalischer Reinigungsmittel bei Temperaturen von Raumtemperatur bis 60 °C in Kombination mit Ultraschallreinigung. Nach der Reinigung werden die Wafer mehrfach mit reinem Wasser gespült und schonend getrocknet (z. B. durch langsames Anheben oder mit Isopropanoldampf getrocknet). Dieses Verfahren erfüllt die Anforderungen an die visuelle und allgemeine Reinheit der Glaswafer.
-
-
Reinigungsprozess für Siliziumwafer
-
Für die Halbleiterverarbeitung werden Siliziumwafer typischerweise einer Standard-RCA-Reinigung unterzogen. Dies ist eine hochwirksame Reinigungsmethode, die in der Lage ist, alle Arten von Verunreinigungen systematisch zu beseitigen und so sicherzustellen, dass die Anforderungen an die elektrische Leistungsfähigkeit von Halbleiterbauelementen erfüllt werden.
-
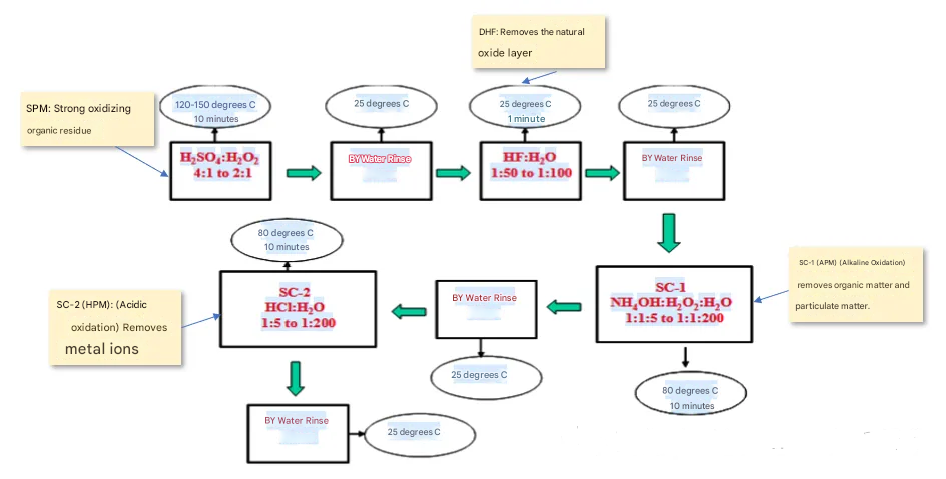
IV. Wenn Glas höheren Reinheitsstandards genügt
Werden Glasscheiben in Anwendungen eingesetzt, die strenge Anforderungen an Partikelanzahl und Metallionenkonzentration stellen (z. B. als Substrate in Halbleiterprozessen oder für exzellente Dünnschichtabscheidungsoberflächen), ist der intrinsische Reinigungsprozess möglicherweise nicht mehr ausreichend. In diesem Fall können Halbleiterreinigungsprinzipien angewendet und eine modifizierte RCA-Reinigungsstrategie eingeführt werden.
Kern dieser Strategie ist die Verdünnung und Optimierung der Standard-RCA-Prozessparameter, um der empfindlichen Natur von Glas gerecht zu werden:
-
Entfernung organischer Verunreinigungen:SPM-Lösungen oder milderes Ozonwasser können zur Zersetzung organischer Schadstoffe durch starke Oxidation eingesetzt werden.
-
Partikelentfernung:Die stark verdünnte SC1-Lösung wird bei niedrigeren Temperaturen und kürzeren Behandlungszeiten eingesetzt, um durch ihre elektrostatische Abstoßung und Mikroätzung Partikel zu entfernen und gleichzeitig die Korrosion des Glases zu minimieren.
-
Metallionenentfernung:Zur Entfernung von Metallverunreinigungen durch Chelatbildung werden verdünnte SC2-Lösungen oder einfache verdünnte Salzsäure-/Salpetersäurelösungen verwendet.
-
Strenge Verbote:DHF (Diammoniumfluorid) muss unbedingt vermieden werden, um eine Korrosion des Glassubstrats zu verhindern.
Im gesamten modifizierten Verfahren wird durch die Kombination mit Megaschalltechnologie die Entfernungseffizienz von Nanopartikeln deutlich gesteigert und die Oberfläche wird schonender behandelt.
Abschluss
Die Reinigungsverfahren für Silizium- und Glaswafer sind das zwangsläufige Ergebnis von Reverse Engineering, basierend auf den Anforderungen der jeweiligen Anwendung, den Materialeigenschaften sowie den physikalischen und chemischen Charakteristika. Bei der Siliziumwaferreinigung wird „atomare Reinheit“ für optimale elektrische Leistung angestrebt, während bei der Glaswaferreinigung die Erzielung „perfekter, unbeschädigter“ Oberflächen im Vordergrund steht. Da Glaswafer zunehmend in der Halbleiterindustrie eingesetzt werden, entwickeln sich ihre Reinigungsverfahren zwangsläufig über die traditionelle schwach alkalische Reinigung hinaus weiter und bringen verfeinerte, kundenspezifische Lösungen wie das modifizierte RCA-Verfahren hervor, um höhere Reinheitsstandards zu erfüllen.
Veröffentlichungsdatum: 29. Oktober 2025
